键合机头号玩家,布局下一代混合键合!

来源:Semiconductor Digest,网络。
韩美半导体(HANMI Semiconductor)近日表示,计划于今年内推出用于新一代高带宽存储器(HBM)生产的第二代混合键合机原型,并开始与客户展开合作。该公司还准备在 2027 年上半年启动其混合键合机工厂的运营。
本公告是公司战略的一部分,旨在主动应对未来对混合键合的需求——预计该技术将于 2029 年左右实现量产——同时进一步巩固其在 HBM 热压键合机市场的领先地位。
混合键合技术直接实现芯片与晶圆之间铜(Cu)互连的键合。该技术摒弃了传统焊料凸点,在降低封装厚度的同时提升了散热性能和数据传输速度,因此对于拥有20层以上的高堆叠HBM而言,其重要性日益凸显。

AMAT & Bsei | 如何采用 Die-to-Wafer 混合键合解决下一代封装的挑战?
此前,该半导体公司于 2020 年率先推出了一款“用于高带宽存储器生产的第一代混合键合机”,由此积累了核心技术与验证诀窍。第二代设备整合了第一代的开发经验与基础技术进行研发,在纳米级精度、工艺稳定性、良率等方面进一步提升了完善度。
韩美半导体还与多家国内半导体设备企业在混合键合相关的等离子体、清洗及沉积技术领域展开紧密合作。
HBM 是一种通过堆叠多层 DRAM 来显著提升数据处理速度的存储半导体。为提升HBM 的性能,必须堆叠更多DRAM层。目前,制造 HBM 所用的设备是 “TC 键合机”,它通过插入凸点(凸起物)来连接 DRAM 层,凸点在层与层之间传输电信号。混合键合机摒弃了凸点,直接将芯片和晶圆上的铜线键合在一起,可实现更薄的DRAM 堆叠。由于当前HBM仅有12 层或16 层,要将 HBM 层数提升至 20 层以上,这种键合机被认为是必不可少的。

Applied Materials | HBM 中 Die to Wafer 混合键合所面临的挑战
韩美半导体正在 Seo-gu, Incheon, Korea 国家产业园区建设一座混合键合机工厂,该工厂计划于明年上半年竣工,总投资达1000 亿韩元。工厂占地面积 14570 平方米,将配备最先进的洁净室。
韩美半导体计划通过 TC 键合机维持稳定营收至 2029 至 2030 年,届时混合键合机预计将进入全面量产阶段。该公司在全球 HBM TC 键合机市场占据约 70% 的份额,位居首位。
在此之前,该公司计划在 2026 年下半年推出一款 “宽 TC 键合机”,以响应市场需求。该设备支持 TSV 和 I/O 数量稳定增长,相比前代技术,能提升存储容量和带宽。
韩美半导体一位高管表示:“我们已将作为 HBM 用 TC 键合机头号供应商的专业技术应用到混合键合机技术中。随着客户着手下一代HBM的量产,我们将在合适的时机交付高度精密的设备。”


Applied Materials,疯狂上新!
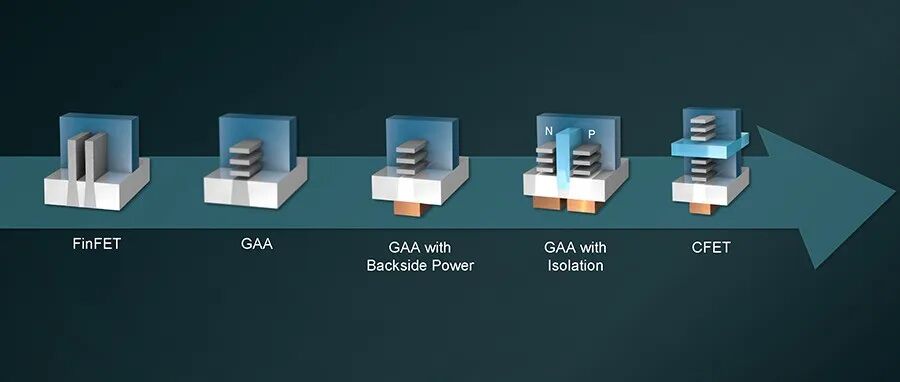
来,让 Applied Materials 告诉我们,先进制程该怎么做?
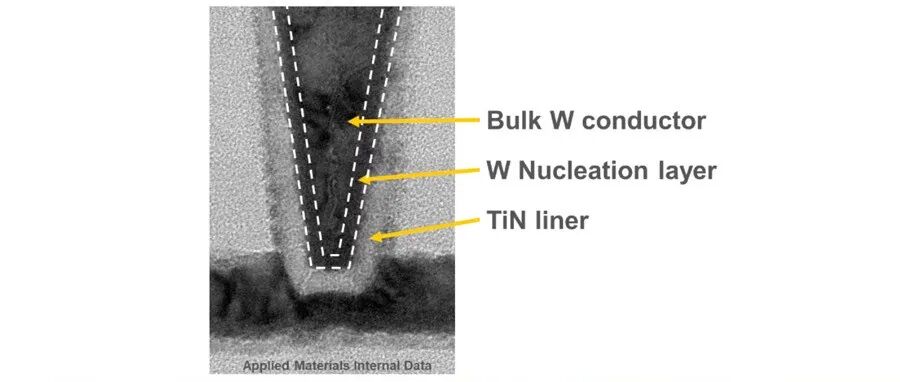
WF6 制备 CVD W !

半导体测试设备厂商获 3000 万美元追加订单!

SK 海力士向 AMAT & Besi 订购混合键合设备
↓设置星标,精彩不错过↓

↓扫一扫,总一款适合你↓

本文仅作行业信息分享、技术交流,不涉及任何涉密内容
欢迎关注本公众号,获取更多半导体设备、工艺、产业动态
如有疏漏、内容建议,欢迎留言交流




