PVD | 长程溅射如何提高侧壁覆盖率?

来源:PVD for Microelectronics: Sputter Deposition Applied to Semiconductor Manufacturing
在 PVD 金属互连工艺中,不管是阻挡层、黏附层又或是种子层在图形(槽或孔)中侧壁的沉积好坏不容忽视,而解决这一问题的基本思路是尽可能使沉积的粒子有足够垂直的角度,这样就能进入图形中。
长程(long-throw)溅射是 PVD 溅射中比较常用的方法,那么,它又是怎样提高薄膜在图形侧壁的覆盖率呢?
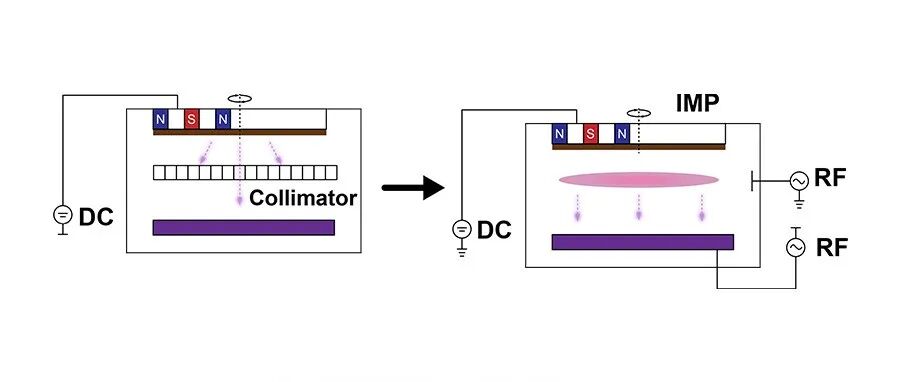
集成电路中的PVD技术路线——从long throw到IMP
在低于 1 mTorr(0.13 Pa) 的气压下进行溅射沉积时,从靶材飞向基片的溅射原子几乎沿无碰撞轨迹运动。若在此低气压条件下增大靶 - 基距,那些以低角度(即近似平行于基片表面)飞行的原子会沉积在腔室侧壁上,只有接近法线入射的原子能够到达基片表面。
因此,增大靶材到基片的距离可对侧向飞行的原子实现几何过滤,使沉积方向更趋于垂直。这一特性可用于提高溅射原子在深孔 / 深槽结构中的沉积占比,并减弱传统溅射的 “外扩沉积” 特征(图 1)。

长程溅射技术(Long-throw)最早应用于剥离(lift-off) 这一早期图形化工艺,该工艺必须依靠定向沉积才能去除基片表面带有轻微悬伸结构的光刻胶掩膜。早期研究中,必须使用空心阴极电子源辅助磁控管放电,才能将气压降至足够低的水平。研究发现,需将工作气压控制在 10⁻⁴ Torr 量级,才能充分减少气体散射,实现接近理想的定向沉积。
目前商用长程溅射设备的靶 - 基距多为 25~30 cm,配套阴极直径约为 30 cm。这种配置的定向过滤效果有限,因此仅适用于深宽比≤1.0 的低深宽比结构。采用长靶 - 基距时,通常需要调整靶材的腐蚀与发射分布:一般需刻意提高靶材边缘区域的刻蚀速率,因为边缘发射的原子会大量损失在腔室侧壁上,只有通过这种补偿才能保证整个晶圆表面的净沉积通量均匀。受系统几何结构影响,平面膜厚均匀性与沉积方向均匀性并不一定正相关,因此平面均匀性不能作为衡量定向沉积效果的可靠指标。
与传统短靶 - 基距工艺相比,长程溅射的沉积速率会显著下降。当靶 - 基距从常规的 30~50 mm 增加到 250~300 mm 的长程距离时,平面沉积速率会降低 5~10 倍,同时腔室内壁和工装夹具上的沉积量会大幅增加。
长程溅射存在一个固有的几何缺陷,如图 2 所示:晶圆不同位置的入射通量方向并不均匀。在晶圆中心区域,入射通量是对称的,其角度发散由靶源边缘所张的立体角决定;但在晶圆边缘区域,由于靶材所张立体角的几何限制,入射通量会变得不对称。
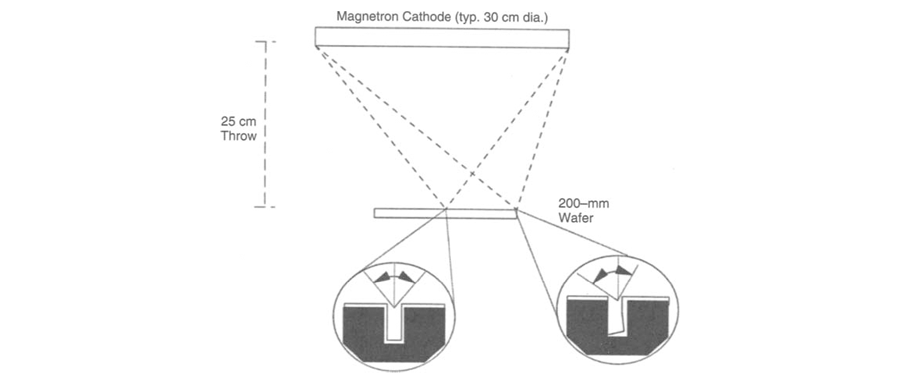
最终导致沟槽朝向晶圆外侧的侧壁接收到的原子远多于朝向晶圆中心的内侧壁,该效应的扫描电镜照片如图 3 所示。
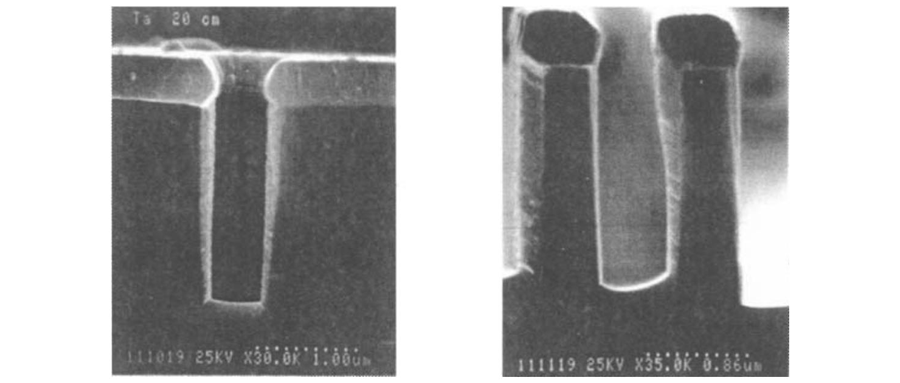
这种沉积不对称性是长程溅射几何结构的固有问题,难以完全消除。通常情况下,沟槽内侧壁的沉积厚度不足外侧壁的 1/3,这不仅会延长实现完全覆盖所需的沉积时间,还会导致外侧壁沉积层过度外扩,对后续沉积产生阴影遮挡效应。
为解决这一问题,最直观的思路是增大靶材直径,但这会使晶圆中心区域的沉积更趋于各向同性(即角度分布更宽)。需要注意的是,增大靶材直径在几何上等价于缩短靶 - 基距。
第二种可行方案是提高阴极边缘的腐蚀速率,以增强向晶圆中心方向的入射通量。但这会恶化平面沉积均匀性(即晶圆边缘的平面膜厚显著高于中心),且这种不均匀性在晶圆最边缘会被进一步放大。尽管从工艺控制角度看这通常是不利的,但有可能使微结构内部的沉积变得相对均匀。
需要说明的是,在大马士革工艺中,顶部平面区域的沉积层最终会通过化学机械抛光(CMP)完全去除;即便如此,CMP 在均匀平整的薄膜上抛光效果最佳,因此仍应尽量避免出现过大的中心 - 边缘膜厚差。
第三种解决沉积不对称性的思路是进一步增大靶 - 基距。当晶圆与靶材的距离足够远时,到达晶圆的沉积通量会更接近法线入射。但从实际应用角度看,靶 - 基距过大会导致沉积速率骤降、气体散射加剧,反而可能降低沉积的定向性。
气体原子的平均自由程近似为:Λ=1/nσ ≈ 5cm/P
其中 n 为气体密度,σ 为动量传递碰撞截面,P 为气压(单位:mTorr)。尽管溅射原子的能量高于背景气体原子,其碰撞截面约小 50%,但要显著增大靶 - 基距,仍必须大幅降低系统工作气压。传统磁控管可在 0.5 mTorr 气压下稳定工作,但要达到 0.1 mTorr 及以下(满足更远靶 - 基距的要求),则需要加装辅助增强装置(如空心阴极电子源)。
长程溅射在量产设备运行方面还存在工程问题:长程溅射腔室的高度通常是传统腔室的 2 倍,腔室体积和内表面积均显著增大,这会导致腔室放气后的抽气时间变长,并略微增加设备运行成本。不过,更大的腔室也为安装更多法兰提供了空间,可相应提升抽气能力或增加诊断接口。
鉴于上述实际且本质性的问题,长程溅射沉积工艺的应用范围相对有限。它仅适用于深宽比 < 1.0 的微结构,在更高深宽比结构中效果不佳。此外,该技术在 300 mm 及更大尺寸晶圆上的扩展性极差:对于 300 mm 晶圆系统,要达到与 200 mm 晶圆相当的定向性,阴极直径需达到约 45 cm,同时靶 - 基距也需增至 45 cm,这对工作气压提出了更高要求,需降至 10⁻⁵ Torr 高位区间。要实现这一气压范围,必须对磁控管进行大幅改造并加装辅助电子源,而这些改造大多与量产应用的要求不兼容。


PVD | 不同靶材溅射原子的角分布
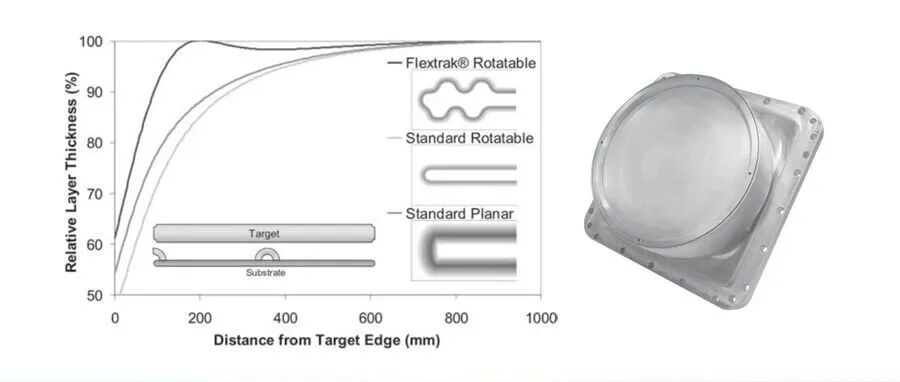
PVD | 如何确定靶材侵蚀轮廓与磁控系统的关系?
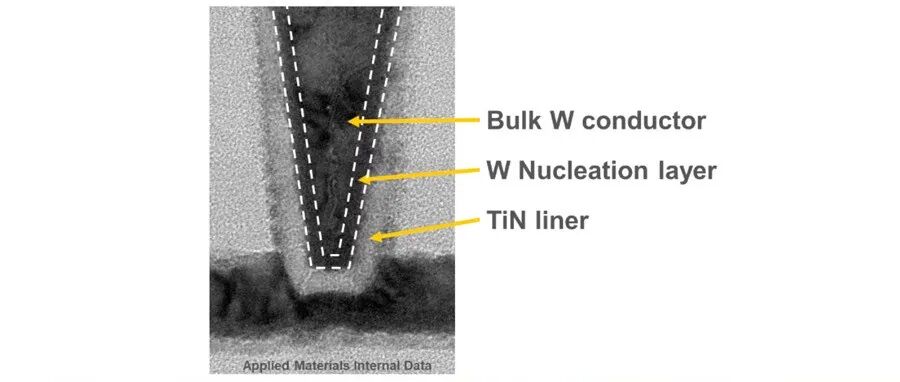
WF6 制备 CVD W !
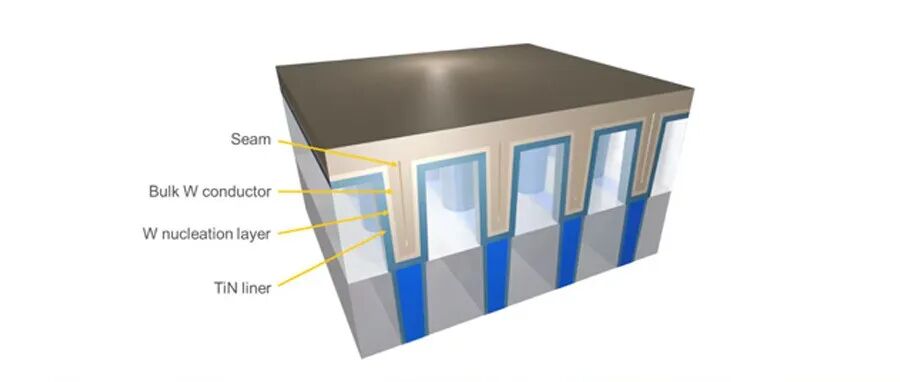
什么样的 TiN 结出什么样的 W?
↓设置星标,精彩不错过↓

↓扫一扫,总一款适合你↓

本文仅作行业信息分享、技术交流,不涉及任何涉密内容
欢迎关注本公众号,获取更多半导体设备、工艺、产业动态
如有疏漏、内容建议,欢迎留言交流




