小小封装,拿下!

来源:Lam Research-Tech Brief: Primer on Packaging
本文简要介绍了一些当今先进封装技术中的基本要素,是一份小小的入门指南。
你有没有曾经打开过智能手机的机身(或许是无意中),看到电路板上贴着小小的黑色矩形块?这些黑色矩形块就是封装好的芯片。芯片的外部封装结构保护着内部脆弱的集成电路,同时还能散热、让芯片彼此隔离,而且至关重要的是,它能实现与电路板及其他元件的连接。制造这些保护性结构和连接的一系列工艺,统称为“封装”。在芯片向更小、性能更强的方向发展的推动下,这一技术领域近年来迎来了革命性的变革。
我们来探讨一下支撑下一代先进封装的部分技术,包括晶圆级封装、凸点制作、再分布层、扇出封装和硅通孔。这些技术充分体现了将前端晶圆制造技术(如沉积、刻蚀和清洗)应用于后端工艺的典型案例。
在传统封装工艺中,成品晶圆会被切割(即划片)成独立的芯片,随后这些芯片会被键合并封装。晶圆级封装(WLP)顾名思义,是在芯片仍位于晶圆上时对其进行封装:可先在晶圆的顶部和/或底部键合保护层,再做好电气连接,最后将晶圆划片成独立芯片。打个烘焙的比方,传统封装就像给单个纸杯蛋糕抹奶油,而晶圆级封装则如同给一整个蛋糕抹奶油后再切片。由于晶圆的侧面未通过晶圆级封装处理,最终封装好的芯片体积很小(与芯片本身尺寸大致相当),这在智能手机等对封装面积敏感的设备中是一项重要优势。其其他优势还包括生产流程更精简,以及能在划片前测试芯片功能。
Bumping and Flip Chips 凸点与倒装芯片
芯片与电路板之间最简单的电气连接之一,可通过名为凸点的导电材料小球实现。随后,可将带有凸点的裸片倒置并对准,使凸点与电路板上对应的焊盘相连接。倒装芯片键合相较于传统的引线键合具有多项优势,包括封装尺寸更小以及器件速度更快。
凸点制作可通过扩展传统晶圆制造方法来实现。芯片制作完成后,会形成凸块下金属化焊盘以与芯片电路相连,随后在焊盘上沉积凸点。焊料是最常用的凸点制作材料,不过根据应用场景的不同,也可选用金、铜或钴等替代材料。对于高密度互连或细间距应用,可采用铜柱。焊料凸点在连接过程中会发生延展,而铜柱则能保持自身形状,这使其可以更紧密地排列。
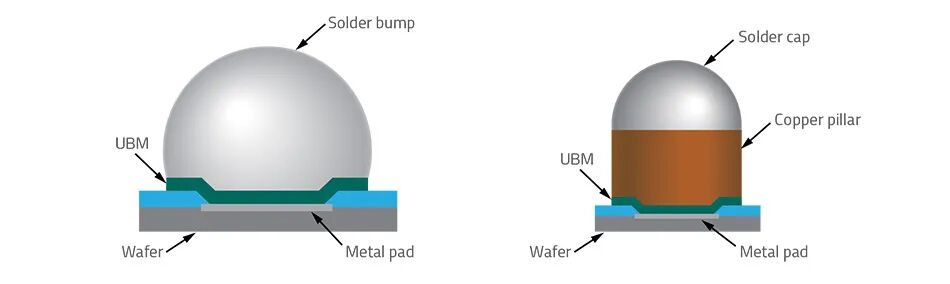
左侧可见一颗直接附着于凸块下金属层(UBM)的焊料凸点(球状结构)。凸块下金属层与金属焊盘相连,金属焊盘铺设在晶圆之上。
右侧为同款结构,区别在于焊料顶盖与凸块下金属层之间增设了铜柱。
Redistribution Layers 重分布层
重新布置或重新分配接触点是另一种可在晶圆级高效完成的技术。重新分布层(RDL)用于将连接线路重新布线至目标位置。例如,位于芯片中心的凸点阵列可被重新分布到芯片边缘附近的位置。这种重新分布接触点的能力可实现更高的接触密度,并为后续的封装工序提供支持。该“扇入”工艺还能制造出目前体积最小的封装件之一。
重分布工艺会在晶圆表面再增加一层结构。首先沉积介电膜以实现电气隔离,随后露出原始焊盘。接着沉积金属线将焊盘重新布置到目标位置,并构建凸点下金属层以支撑焊料(或其他金属)凸点。
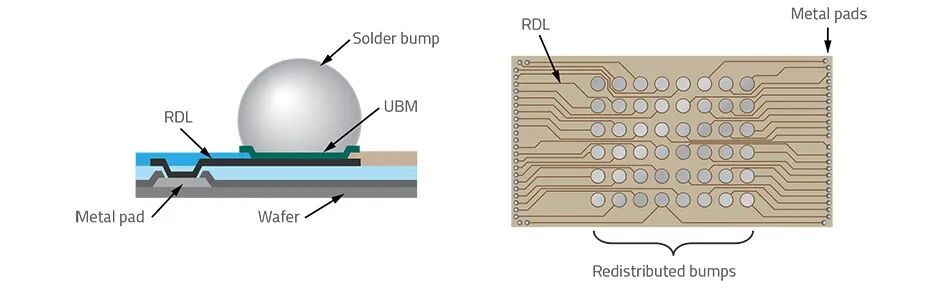
Fan-Out WLP 扇出式晶圆级封装
重分布工艺还可用于分散或“展开”连接点。例如,当芯片尺寸缩小但需要相同数量的接触点时,就可能需要这一工艺。一种解决方案是将触点展开至芯片尺寸之外。这项技术的一个重要应用是提升电气和热性能,同时降低封装的整体高度。
扇出晶圆级封装(FOWLP)通常首先将经过前端工艺处理的晶圆切割为独立芯片。随后将这些芯片在载体结构上隔开排列,并填充间隙以形成重构晶圆。一旦构建出人工晶圆,便可借助晶圆级封装工艺将触点重新分布至原芯片边缘之外。

Through-Silicon Vias 硅通孔
尽管凸点和再分布层(RDL)可能会减小芯片在电路板上占用的表面积,但将芯片堆叠起来时,空间利用率会更高。更优的是,堆叠是一种能提升多芯片电气性能的策略。引线键合是实现堆叠组件的一种方式,而硅通孔(TSVs)已成为一种颇具吸引力的替代方案,可实现更小的外形尺寸。硅通孔是贯穿芯片整个厚度的电气连接,构建了从芯片一侧到另一侧的最短路径。芯片之间较短的互连长度还意味着更低的功耗和更高的带宽。
在一种常见的硅通孔制备方法中,先从晶圆正面刻蚀出通孔(孔洞)至特定深度。随后通过沉积导电材料(通常为铜)对这些通孔进行隔离并填充。芯片制造完成后,从晶圆背面对其进行减薄以露出通孔,再在晶圆背面沉积金属,从而完成硅通孔互连。
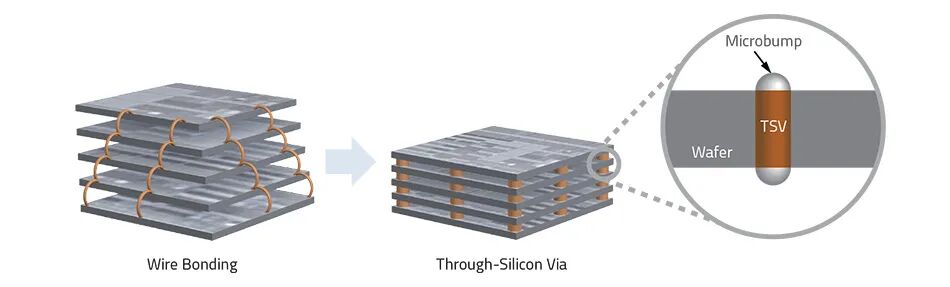
该图示展示了芯片的两种堆叠连接方式:引线键合与硅通孔技术。引线键合将每颗芯片的边缘与下方芯片的边缘相连,层层接续,直至最底部的芯片。
而采用硅通孔技术时,会在每颗芯片上垂直钻孔,硅通孔结构从所有芯片的同一固定位置贯穿全部孔洞,连通整叠芯片,整体结构外观类似立体停车楼。
封装在半导体制造流程中已不再是事后才考虑的环节,而是迎来了爆发式的创新与复杂度提升。尤其是晶圆级封装,其材料、工艺和设备都取得了巨大进步,使得晶圆级封装成为增长最快的芯片封装技术之一。凸点、再分布层、扇出、硅通孔等技术的应用,造就了体积小巧且具备强大高速性能的芯片,这也正是消费者在移动电子设备中所期待的体验。我们期待看到由先进封装技术赋能的下一代半导体器件问世。

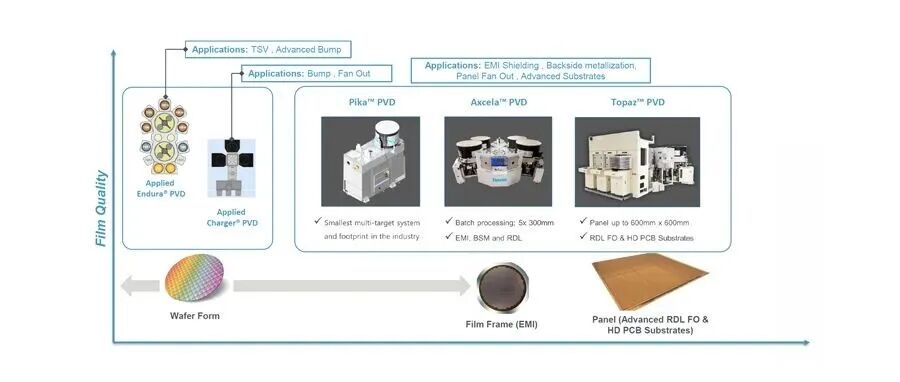
Applied Materials | 半导体封装中的 PVD 技术
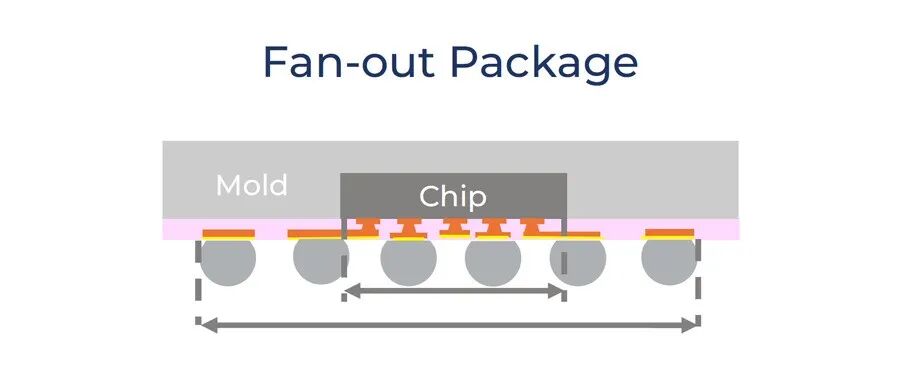
日月光 | 半导体封装 FOPLP 技术的机会与挑战

AMAT 继续加码先进封装!

AMAT & Bsei | 如何采用 Die-to-Wafer 混合键合解决下一代封装的挑战?
↓设置星标,精彩不错过↓

↓扫一扫,总一款适合你↓

欢迎关注本公众号,获取更多半导体设备、工艺、产业动态




