新突破!国创中心(苏州)攻克大尺寸碳化硅晶锭激光隐形切割关键技术

近日,由江苏第三代半导体研究院有限公司、国家第三代半导体技术创新中心(苏州)联合承担的江苏省集萃研究员项目“六英寸碳化硅晶锭激光隐形切割技术研发”取得重大技术突破。该技术在切割效率、良率、损伤控制及减薄精度等核心指标上实现全方位提升,可大幅降低大尺寸碳化硅衬底加工成本,为我国宽禁带半导体产业高质量发展注入强劲动力。

作为第三代半导体核心材料,碳化硅凭借优异的综合性能成为产业发展的关键支撑。其室温禁带宽度、击穿场强、电子饱和漂移速度及导热系数均远超传统硅材料,分别达到硅材料的3倍、10倍、2倍和3倍,广泛适用于大功率器件、射频器件制造,其中半绝缘碳化硅更是AR显示终端的核心材料。然而,碳化硅单晶莫氏硬度高达9.5级,仅次于金刚石,加工难度极大,长期以来制约着产业规模化发展。
目前行业主流的钢丝线多线切割技术存在明显短板:6英寸碳化硅晶锭切割需100-120小时,单片切割耗时约3小时;8英寸晶锭切割需160-200小时,单片耗时达5-5.5小时,且存在材料损耗大、切缝损失明显等问题。据统计,线切割成本占碳化硅衬底总成本的25%-30%,因此优化切割工艺、降低加工成本与耗时,成为宽禁带半导体产业突破发展瓶颈的关键。
针对这一行业痛点,科研团队聚焦激光隐形切割技术研发,系统研究其物理机理、碳硅非晶态改质层形成机制及特征表征,优化激光切割参数与高效率剥离技术,成功攻克大尺寸碳化硅晶锭激光隐形切割、高精密减薄及化学抛光等一系列关键难题。
该技术的核心优势的在于“由内而外”的无损切割,利用激光光学非线性效应,使激光穿透晶体表面并在内部聚焦,通过诱导碳与硅原子热致开裂、化学键断裂等物理化学过程,形成非晶态碳硅改质层,在外力作用下实现晶片无损剥离,有效避免了传统机械切割带来的崩边、微裂纹等缺陷。

在关键性能指标上,该技术实现多重突破:6英寸碳化硅晶锭单片切割时间缩短至9.5分钟以内,较传统线切割效率提升近20倍,切割厚度覆盖120-1030μm,可满足不同规格衬底加工需求,改质层剥离时间平均不足30秒,损伤层小于40μm,切割良率达99%;8英寸晶锭单片切割时间控制在17-23分钟,效率提升近15倍,损伤层小于50μm,良率同样达到99%,且对不同质量的晶锭具有极强普适性,推广后可使大尺寸碳化硅衬底加工成本降低50%以上。
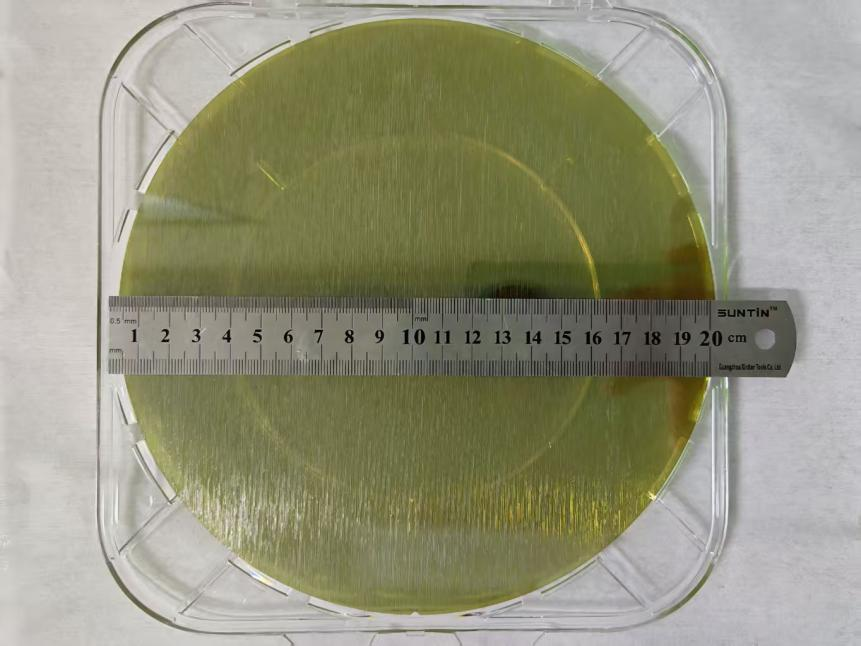
除切割技术外,团队在高精密减薄领域也取得重要进展。8英寸碳化硅晶片经精密减薄后,厚度均匀性(TTV)小于1μm,局部均匀性(LTV)小于0.5μm,表面粗糙度(Ra)小于1.50nm,为后续抛光、外延工艺奠定良好基础,同时可加工光学级碳化硅材料,拓展至AR显示等前沿应用领域。
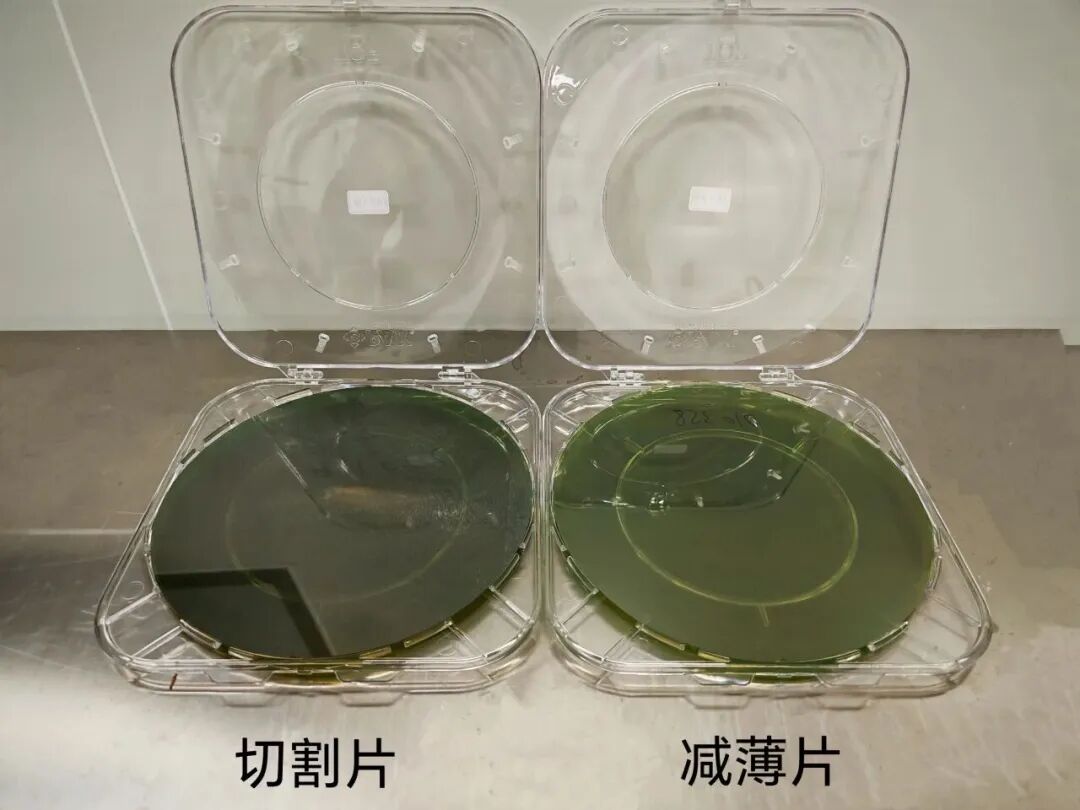
据悉,该项目拥有完全自主知识产权,目前已申请相关专利20项,其中5项获得授权。后续,科研团队将持续深耕切割材料多样性、适应性及切割品质与效率优化,进一步推动技术成果转化,为我国宽禁带半导体产业降本增效、实现自主可控提供重要技术支撑。





2026先进半导体封装技术与应用论坛(CASPF 2026)邀您5月共赴江南之约!
为更好的推动国内先进半导体封装技术与应用交流,在第三代半导体产业技术创新战略联盟(CASA)指导下,江南大学、极智半导体产业网和第三代半导体产业联合主办,将于2026年5月15-17日举办“2026先进半导体封装技术与应用论坛(CASPF 2026)”。论坛内容将围绕硅、碳化硅、氮化镓等集成电路封装技术,涉及先进半导体材料,器件,封装工艺、装备、制造、应用等相关主题,邀请产业链相关专家、高校科研院所及知名企业代表共同深入探讨,追踪先进半导体封装最新技术进展,分享应用及相关生态链构建发展,携手促进先进半导体封装技术协同发展。——CASPF2026 首批嘉宾揭晓!江大先进半导体封装技术与应用论坛邀您5月共赴江南之约!



【赞助、展示及商务合作】
张女士:13681329411 贾先生:18310277858

