开盘涨超406%!无锡再添千亿IPO
点击蓝字
关注我们


2014年8月,中芯国际与长电科技宣布签约,在江阴合资成立中芯长电半导体,是一家专注于12英寸晶圆中段加工的合资企业。仅一年后,2015年,中芯长电完成生产工艺调试与产品认证,并在第二轮增资中引入中芯国际、国家集成电路产业基金(大基金一期)和高通三方资金,合计2.8亿美元。
2016年,中芯长电成功为高通实现14纳米硅片凸块的量产交付,成为大陆首家切入14nm先进制程产业链并实现量产的企业,也是大陆第一家为高端DRAM和12英寸电源管理芯片提供凸块加工服务的公司。
命运的转折发生在2021年。中芯国际以3.97亿美元完成股权剥离,中芯长电随即更名为盛合晶微。
剥离后不到半年,盛合晶微即完成总额3亿美元的C轮融资,引入光控华登、碧桂园创投等市场化机构。C+轮融资3.4亿美元,新增君联资本、TCL创投等股东;Pre-IPO轮融资7亿美元,引入无锡产发科创基金、上海国投孚腾资本及社保基金中关村自主创新基金等长期投资者。历史总融资额超过13亿美元。

盛合晶微以12英寸中段硅片加工为基础,向上延伸至晶圆级封装(WLP)和芯粒多芯片集成封装,构建起覆盖凸块制造(Bumping)、晶圆级芯片尺寸封装(WLCSP)、2.5D/3D集成封装的全流程服务体系。
按营收结构来看,该公司的业务重心正在发生明显转移。2022年至2025年上半年,硅片加工业务占比由67.4%下降至31.32%,而芯粒多芯片集成封装业务占比由5.32%大幅提升至56.24%,已成为最主要的收入来源。芯粒多芯片集成封装业务收入从2022年的8604万元快速攀升至2024年的20.79亿元,2025年上半年已达17.82亿元。
技术方面,盛合晶微2.5D集成已形成规模化量产。根据灼识咨询统计,2024年公司是中国大陆2.5D收入规模第一的企业,市占率约85%。3D Package业务于2025年5月进入量产阶段。在更前沿的方向上,他们正重点布局2.5D/3DIC,涵盖微凸块和混合键合等主流方案,并通过本次募投项目中的“超高密度互联三维多芯片集成封装项目”(总投资30亿元)推进3DIC技术平台形成规模产能。
盛合晶微选择此时登陆资本市场,背后有清晰的产业逻辑支撑。当前,AI算力基础设施的竞争正从芯片前端制造向后端封装环节蔓延,先进封装已成为决定AI芯片量产能力的关键瓶颈。
据Yole Group数据,2025年全球先进封装市场规模约531亿美元,预计2030年将达794亿美元,年复合增长率约8.4%。其中,2.5D/3D封装是增长最快的细分领域,其驱动力来自单一芯片物理面积逼近光刻极限后的必然选择:将多颗芯粒(Chiplet)通过高密度互连集成为“超级芯片”,典型代表即英伟达GPU+SK海力士HBM所采用的台积电CoWoS封装方案。
台积电目前占据全球CoWoS产能的85%以上,英伟达已预订其2026年约80—85万片晶圆产能,占台积电同期总封装产能的50%以上。即便如此,产能排期仍已延至2027年后。与此同时,全球OSAT龙头日月光也将其LEAP先进封装业务营收目标从2025年的16亿美元翻倍至2026年的32亿美元。国际龙头纷纷扩产的背后,反映出先进封装已从“可选配套”升级为“核心产能瓶颈”。
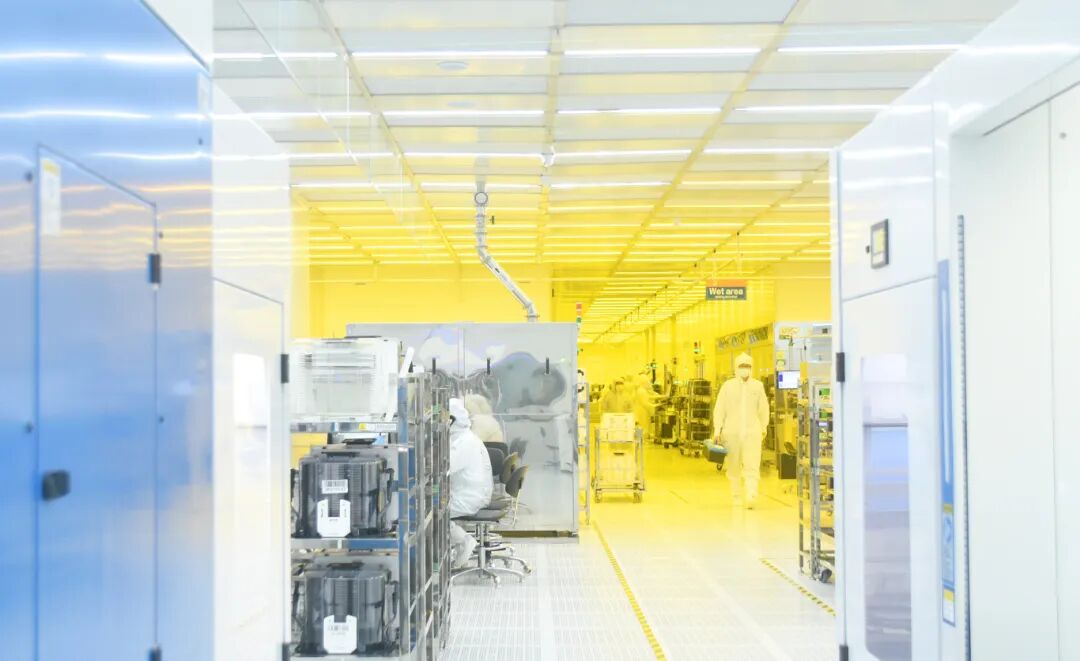
当台积电高端CoWoS产能被海外AI厂商锁定,国内GPU、AI芯片设计公司的先进封装需求面临严重的外部供给依赖。盛合晶微所处的芯粒多芯片集成封装赛道,正是这一供给缺口最直接的本土承接方。
其差异化优势体现在三个层面:首先,盛合晶微是国内大陆唯一具备12英寸中段硅片加工+芯粒封装全流程的一站式服务商;其次,最早实现14nm先进节点产品的量产落地;第三,在三维多芯片集成封装(3D-IC)领域拥有先发技术储备。
然而,从全球市场份额来看,该公司目前占比仅约1.6%,远低于日月光、安靠等国际OSAT龙头,即便在国内封测厂商中也排在长电科技、通富微电、华天科技之后,规模差距依然显著。
与此同时,政策层面的催化效应持续释放。国家集成电路产业投资基金(大基金)已多轮布局先进封装,上海、无锡、合肥等地也相继设立配套产业基金,“先进封装”已被明确纳入国家集成电路重点攻关方向。
盛合晶微的上市,是国内先进封装产业链从孵化走向自主的一个缩影。其凭借12英寸中段加工与芯粒集成的全流程能力,在国产AI芯片封装缺口扩大的窗口期内确立了先发地位。但全球份额偏低、客户高度集中、技术迭代压力及地缘政治不确定性等风险同样不容忽视。对于市场而言,这家公司的价值不仅在于其自身的成长性,更在于为国产先进封装能否真正突破“卡脖子”环节提供了一次重要的观察样本。
- END -


推荐关注

