异质异构集成时代:晶圆键合如何支撑下一代光电子芯片?


在数据中心互联、激光雷达、高速光通信与 AI 算力芯片快速发展的今天,异质异构集成已成为突破光电子芯片性能上限的主流技术路线。将高效发光的 Ⅲ‑Ⅴ 材料与高集成度、低成本的硅光子平台融合,是当前最具产业化前景的方案,而实现这一路线的核心基础,正是晶圆键合。
晶圆键合不仅是 “把两片晶圆粘在一起”,更是决定芯片集成度、良率、损耗与可靠性的关键工艺。依托成熟工艺与顶刊验证成果,光谷实验室已形成从晶圆键合→芯片全流程加工→测试验证→可靠性分析的一站式光电子集成解决方案。
一、晶圆键合:异质集成的核心入口
当前平台已具备两类标准化、高稳定性的晶圆键合能力,可支撑从科研到工程的全场景需求:
Wafer to wafer 整片晶圆键合
支持 2–6 寸晶圆,兼容 Si、InP、SiO₂、Si₃N₄等多材料体系
采用 20 nm Al₂O₃ 作为键合介质
经 300℃真空退火 强化界面结合力
键合良率 >94%,界面无气泡、低损耗

Die to wafer 芯片对晶圆键合
高精度对准,误差 ±0.5 μm
键合层厚度 10–20 nm
键合良率 ≥80%适合 Ⅲ‑Ⅴ 器件贴装、异质光源、光电模组等小尺寸高精度集成。

二、顶刊实证:晶圆键合支撑高性能 L 波段光芯片
基于上述键合工艺,最新研究成果发表于国际光学顶刊 Optics Express (2026),实现了硅基异质集成器件的重大突破:
✦ L波段宽可调谐激光器
调谐范围:43 nm(1571–1614 nm)
边模抑制比:>45 dB
输出功率:9.15 mW
✦ 高增益半导体光放大器(SOA)
小信号增益:21 dB
饱和输出功率:13 dBm
两类器件共享外延结构与制造流程,显著降低高密度集成成本,是数据中心、激光雷达、超宽带 WDM 系统的理想光源方案。
三、从键合到流片:全流程芯片加工能力
晶圆键合之后,平台可直接完成异质集成芯片全链条制造,真正实现 “来料→成品器件” 一站式交付:
光刻:DUV / 电子束光刻,最小线宽 150 nm
刻蚀:ICP 高精度刻蚀,波导粗糙度 5 nm
镀膜:LPCVD/PECVD/ 电子束蒸发全覆盖
器件:硅基波导、Ⅲ‑Ⅴ 增益区、耦合锥、微环、热调谐结构全流程
可稳定支撑硅光芯片、Ⅲ‑Ⅴ/ 硅异质集成光源、探测器、光放大器等高端器件流片。
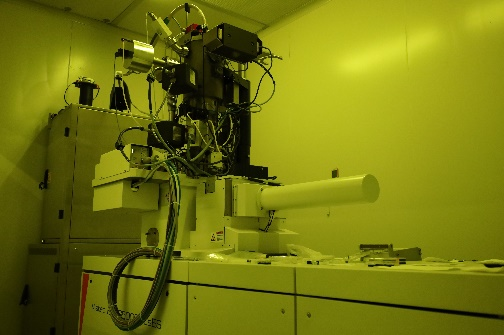
四、全链条配套:测试 + 封装 + 可靠性一站式服务
围绕晶圆键合与芯片加工,平台同步开放完整支撑能力,形成研发 — 制造 — 验证闭环:
高端成像测试:单像素、光谱压缩、时域压缩成像
X 射线标准测试:DQE、闪烁体光产额(IEC 62220‑1)
封装工艺:金线键合、COB/TO/ 气密性封装
可靠性验证:高低温循环、高温高湿老化
失效分析:纳米级定位,提供工艺改进方案

现在平台面向高校课题组、科研院所、光芯片企业提供:晶圆键合、异质集成加工、芯片流片、测试表征、可靠性验证等全流程服务。有需请联系:梅老师13618635885。扫码填写需求


